常溫濺射類金剛石DLC膜涂層的工藝研究
發布時間:2017-07-05
1、引言
DLC薄膜是碳的一種非晶亞穩態結構,在微觀上它主要由一定比例的sp3鍵和sp2鍵混合組成。它具有類似于金剛石的優良的力學、機械和化學特性,同時是一種性能良好的紅外材料,可用于紅外探測、紅外遙感及測溫系統、紅外窗口材料表面的增透保護膜。
磁控濺射是制備DLC膜的常用方法。采用磁控濺射法,在室溫下開展其制備工藝的研究,對于這一新型薄膜材料應用于紅外技術及光電技術有著重要的意義。沉積速率是表征成膜過程的物理量,是控制薄膜厚度、滿足膜系設計要求的重要參數。研究工藝參數對沉積速率的影響規律不僅可以指導鍍膜實踐、實現多層膜的設計和制備,而且有助于理解磁控濺射的機理。本文研究了濺射功率、氣體流量比、濺射頻率、基底負偏壓等工藝參數對DLC膜沉積速率的影響和薄膜的光學性能,為磁控濺射法沉積的DLC膜在紅外系統上的應用奠定基礎。
2、實驗
實驗設備采用脈沖磁控濺射鍍膜系統,室溫下在單晶Ge基片上沉積DLC薄膜。濺射靶材是高純的石墨,原料氣體是高純氬氣(99.995%)和一種碳氫氣體。制備過程中選擇的工藝參數范圍為:濺射功率1000~3000W,氣體流量比CH:Ar=0.075,~0.175,濺射頻率5O~160kHz,基底負偏壓10~100V。采用傅里葉變換紅外光譜(FT-IR)對薄膜進行透射曲線的測量,并通過透過率曲線計算薄膜厚度。沉積速率R用所得薄膜的平均厚度d除以沉積時間t來計算。薄膜的具體工藝參數如表1所示。

3、結果與討論
3.1 濺射功率對沉積速率的影響
實驗研究發現濺射功率是影響沉積速率的一個最直接的因素。通過樣品1#、2#、3#、4#的透過率曲線,計算薄膜的厚度。圖1給出了樣品1#、2#、3#、4#的沉積速率與濺射功率之間的關系曲線。

從圖1中可以看出隨著濺射功率的增加,沉積速率顯著增大。這是因為濺射功率的大小會影響放電等離子體的強弱和濺射效率。濺射功率增大時,離子流與自偏壓同時增大,離子流的增大導致參與濺射的離子數量增多,自偏壓的增大使濺射原子的產額增加。因此,磁控濺射DLC薄膜中沉積速率隨濺射功率的增大而增大。
3.2 碳氫氣體與氬氣流量比對沉積速率的影響
在磁控濺射過程中,氣體流量比是非常重要的參數。圖2是樣品5#、4#、6#的沉積速率與氣體(碳氫氣體與氬氣)流量比之間的關系曲線。

從圖2中可以看出,隨著碳氫氣體與氬氣流量比的增加,沉積速率增大,在流量比為0.125時沉積速率達到最大;隨著碳氫氣體與氬氣流量比的繼續增大,沉積速率降低。當碳氫氣體與氬氣流量比值很小時,反應濺射保持了同純氬濺射相似的濺射產額和沉積速率;隨著碳氫氣體與氬氣流量比值的增大,碳氫氣體與碳靶反應,參與襯底上成膜,同時氬氣提供濺射離子,使得沉積速率提高;當碳氫氣體與氬氣流量的比值過高時,碳氫氣體除了與碳靶反應、參與襯底上成膜、被真空室吸附以及被抽氣系統抽走之外,還有剩余。剩余的碳氫氣體將在碳靶表面生成一層碳的化合物,使靶完全中毒,抑制了碳靶的濺射,導致沉積速率的下降。
3.3 濺射頻率對沉積速率的影響
改變濺射頻率,在其他的工藝參數相同的條件下得到沉積速率與濺射頻率之間的關系。圖3是樣品4#、7#、8#的沉積速率與濺射頻率之間的關系曲線。從圖中可以看出沉積速率隨濺射頻率的減小而線性增大。當工作場強為定值時,頻率越高,等離子體中正離子被加速的時間越短,正離子從外電場吸收的能量就越少,轟擊靶的正離子能量也越低,靶的濺射速率也越低。

3.4 基底負偏壓對沉積速率的影響
改變基底負偏壓,在其他的工藝參數相同的條件下得到沉積速率與基底負偏壓之間的關系。圖4為樣品4#、9#、1O#、11#所得沉積速率與基底負偏壓之間的關系曲線。
從圖中可以看出:當負偏壓由1OV增大到80V時,沉積速率逐漸增大;當負偏壓由80V增大到100V時,沉積速率有所下降。這是因為當襯底上加適當負偏壓時,可以有效的提高沉積粒子與襯底結合、相互之間形成薄膜時的結合力以及薄膜致密性。實驗發現80V是最好的基底負偏壓。
通過上述研究,得到獲得最佳的工藝參數為:濺射功率3000W,碳氫氣體與氬氣流量比0.125,濺射頻率5OkHZ,基底負偏壓80V。通過傅里葉變換紅外光譜(FT-IR)對此樣品進行透過率曲線的測量。測量結果如圖5所示。

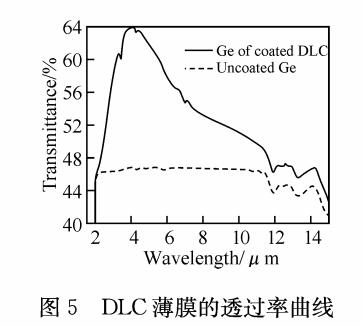
從圖5中可以看出,常溫下,采用磁控濺射技術在Ge基底單面上制備DLC膜的透過率達到63.99%(4.03um),與理論值十分接近(如果將Ge的折射率按4.0計算,理論峰值透過率是64%)
4、結論
本文在常溫下,采用磁控濺射技術成功地在Ge基底上制備了DLC膜,得出以下結論:
1)磁控濺射DLC薄膜中沉積速率隨濺射功率的增大而增大,隨濺射頻率的減小而增大;隨碳氫氣體與氬氣流量比、基底負偏壓的增大先增大后降低,出現極大值。
2)獲得最佳的工藝參數:濺射功率3000W,碳氫氣體與氬氣流量比0.125,濺射頻率5OkHz,基底負偏壓80V。
3)Ge基底上單面制備DLC膜的透過率達到63.99%(4.03um),與理論值十分接近紅外光學系統的需求。
聲明:本站部分圖片、文章來源于網絡,版權歸原作者所有,如有侵權,請點擊這里聯系本站刪除。
| 返回列表 | 分享給朋友: |
- 上一篇:DLC類金剛石薄膜涂層及其研究進展
- 下一篇:三種中頻對靶磁控濺射類金剛石膜的性能…








 京公網安備 11010502053715號
京公網安備 11010502053715號